
2026中国(合肥)国际半导体与集成电路产业展览会
2026年5月22-24日 合肥滨湖国际会展中心



半导体行业正处于一个关键时刻。
人工智能正以前所未有的力度重塑这个行业。这不仅仅是又一轮应用浪潮,而是一场深刻的结构性转型。然而,机遇与挑战并存——电力限制、供应链压力、成本攀升、技术复杂性,这些挑战如今已远远超出了传统的晶体管微缩范畴。
在近日举行的SEMI产业战略研讨会(ISS)上,AMD技术与产品工程高级副总裁Mark Fuselier和英特尔晶圆代工执行副总裁Naga Chandrasekaran分别发表主题演讲,从互补的视角揭示了AI时代半导体的演进方向。
他们的核心判断高度一致:半导体创新正在从以器件为中心的微缩,转向对工艺、封装、架构和系统集成的整体优化。
AI驱动:半导体增长的新引擎
两位发言者都强调,人工智能不仅仅是又一波应用浪潮,而是从根本上重塑了对半导体技术的要求。
“我们都应该为自己所取得的成就感到自豪,”Chandrasekaran在回顾行业推动AI快速发展的历程时说道,“但这些成就的基础,早在几十年前就已奠定。”
增长规模前所未有。AI工作负载——尤其是大型语言模型和生成式AI系统——对计算能力、内存带宽和互联吞吐量提出了指数级需求。训练集群如今由数千到数万个加速器组成,以纵向和横向扩展架构连接,这显著增加了系统级功耗和数据传输需求。
这种转变从根本上改变了创新发生的地点。计算扩展不再局限于芯片层面,而是发生在集群层面——网络效率、散热限制、电源供应,都直接影响着可实现的性能。
Fuselier点出了挑战的严峻性:如今训练前沿模型可能需要长时间的超大规模计算。“从商业角度来看,这行不通,”他强调,必须用效率取代蛮力扩展。
能效为王:设计约束的重塑
从历史上看,半导体技术的进步主要通过频率提升和晶体管密度来衡量。在AI时代,每瓦性能已成为关键指标。
节能型AI架构的逻辑是:在提高总计算吞吐量的同时,降低每次操作的能耗。根据Fuselier和AMD工程师最近发表的技术成果,提高加速器效率可直接提升数据中心级效率——因为它可以减少达到性能目标所需的节点数量,从而降低网络开销和冷却需求。
这一转变源于AI工作负载的特性:以并行计算和数据传输为主,而非串行执行。因此,缩短计算与内存之间的距离,成为降低能耗的有效手段之一。
缩短数据路径可降低延迟和每比特传输能耗,使得异构集成和内存邻近成为重要的设计策略。先进的封装技术,如3D堆叠,可以更紧密地集成计算和内存,从而降低数据传输能耗。
Fuselier将这种演变描述为一种范式转变:以更低的电压提供计算能力,而不是最大化频率。更低的运行电压可降低动态功耗——在高利用率的AI数据中心环境中,这正是能耗的主要来源。
Chiplet与3D集成:架构协同的新路径
节能型AI架构正越来越多采用基于芯片组的方法。模块化设计允许每个功能模块使用最合适的工艺节点制造,从而提高性能和能效。
近期的加速器设计体现了这一转变。以AMD的MI300架构为例:它通过2.5D中介层技术集成了多个加速器复合体芯片和输入/输出芯片,同时采用3D堆叠提高计算密度并降低能耗。集成大容量封装内缓存,可减少DRAM访问次数,并通过缩短内存和计算引擎之间的路径来降低平均内存访问能耗。
这种架构方法反映了更广泛的行业趋势。提高AI规模的计算密度和效率,已无法仅靠晶体管微缩实现。相反,设计技术协同优化——将架构选择与封装和工艺技术相结合——正变得日益重要。

这意味着:系统架构决策对能效的影响,已与工艺节点选择同样值得关注。
工艺技术:节能计算的三大方向
尽管封装和架构日益受到关注,但工艺技术仍然是提升能效的基础。
节能计算优化主要集中在三个方面:动态与静态功耗优化、寄生效应降低、器件静电性能改进。
降低电源电压是降低动态功耗的有效手段之一,但它会带来漏电功耗和性能波动方面的权衡。因此,实现效率提升需要晶体管设计、物理布局和架构之间的协调优化。
新兴器件结构,如互补场效应晶体管——垂直堆叠NMOS和PMOS纳米片,通过减小逻辑面积和导线长度并改善静电性能,为实现这一目标提供了途径。研究表明,通过此类方法,芯片级功耗有望降低约30%。
这些进展强化了ISS中反复提到的一个主题:工艺创新需要服务于系统级效率目标,而不仅仅是独立的器件指标。
封装:从辅助到关键
半导体创新领域的一个重要变化,在于封装技术从辅助角色逐步成为关键性能驱动因素。
先进的封装技术突破了光罩尺寸限制,实现了更高集成度,并通过高密度互连提升了能源效率。硅中介层和短距离芯片间连接,使芯片组能够以接近片上金属互连的带宽进行通信,与传统板级连接相比,能源效率显著提升。
3D互连技术进一步提升了效率。混合键合和硅通孔技术实现了垂直连接,与传统微凸点连接相比,互连能效有数倍提升。
这些技术对于AI工作负载尤为重要,因为数据传输能耗在系统总功耗中占据较大比例。
电源供应和散热管理也成为设计中的重要挑战。功率超过1000瓦的AI加速器需要集成电压调节、深沟槽电容器和先进的导热界面材料,以维持效率和可靠性。散热管理直接影响系统级能耗——温度升高会增加漏电功耗,对计算性能产生影响。
互连:系统扩展的新课题
随着AI集群规模扩大到数千个加速器,系统互连效率变得与芯片级性能同等重要。
在数据速率持续提升的背景下,电互连正接近实际极限,这推动了业界对光互连和共封装光学器件的关注。将硅光子学与计算硅集成,为降低长距离数据传输功耗提供了可行途径。
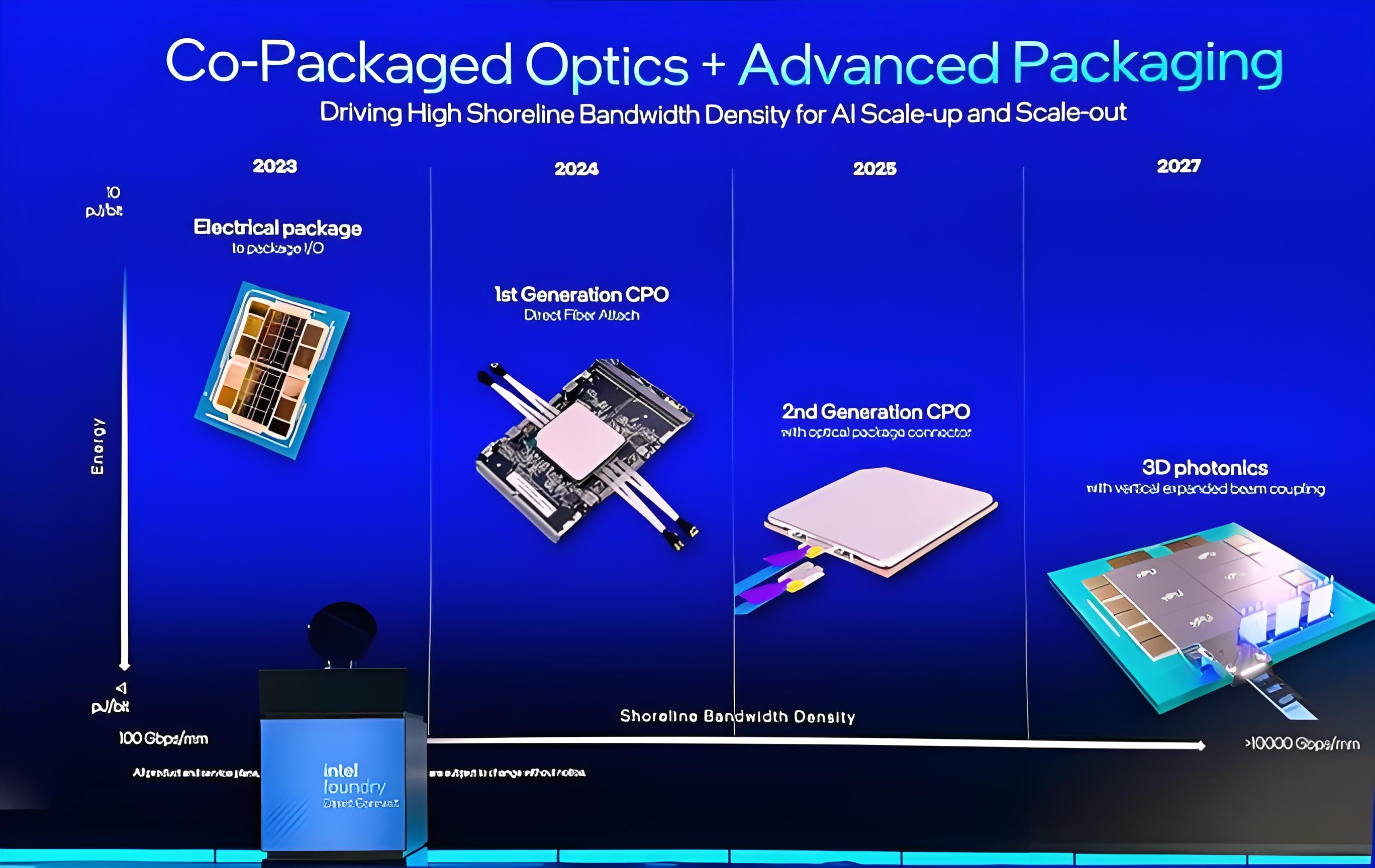
Fuselier和Chandrasekaran都提到:互连技术需要被视为战略技术。未来的性能提升,将取决于封装、网络和系统架构的协同创新。
制造复杂性与生态协作
该行业面临的技术挑战与经济挑战并存。目前,最先进的晶圆厂需要数百亿美元的投资,而制程节点的转换则涉及日益复杂的工程技术。
Chandrasekaran将现代半导体制造描述为“以原子级精度运行”。他强调“我们实际上是在一次控制一个原子”,以此凸显维持创新所需的工程规模。
与此同时,供应链的复杂性已从晶圆和设备扩展到材料、劳动力供应和基础设施等多个方面。AI的蓬勃发展加剧了这些压力——需求增长速度超过产能增长速度。
技术论文和主题演讲中反复出现的一个主题是:生态系统协调的重要性。节能型AI架构需要硬件制造商、软件开发商和材料供应商之间的合作。共享标准和开放生态系统,使投资能够更集中,有助于加快技术迭代并降低供应链风险。
Fuselier提到,围绕通用规范达成一致,对于高效扩展产能和创新具有积极意义。这种协作方式不仅体现在技术层面,也延伸至人才培养和产业投入,为半导体行业的持续发展提供支撑。
结语
站在AI时代的门槛上,半导体行业的创新路径逐渐清晰:从以器件为中心的微缩,转向对工艺、封装、架构和系统集成的整体优化。
这个行业正在经历的,不仅是一场技术变革,也是一场思维方式的演进。
未来的发展,将有赖于在系统层面思考和生态系统中协同创新的能力。
大芯片行至十字路口,方向已然清晰。
免责声明:本文内容来源于公开资料,仅供参考。我方转载出于传递更多信息之目的,不构成任何投资建议。如涉及版权问题,请及时联系,我们将第一时间处理。